Hệ thống FIB-SEM ba chùm tia NX2000
Hướng tới hệ thống chuẩn bị mẫu TEM tối ưu
Các hệ thống FIB-SEM đã trở thành một công cụ không thể thiếu để đặc tính hóa và phân tích các công nghệ mới nhất cũng như các vật liệu nano hiệu suất cao. Nhu cầu ngày càng tăng đối với các lá TEM siêu mỏng không để lại lỗi kỹ thuật trong quá trình xử lý FIB đòi hỏi những công nghệ quang học ion và electron tốt nhất.
Hệ thống FIB hiệu suất cao và SEM độ phân giải cao NX2000 của Hitachi, với các công nghệ độc quyền về kiểm soát hướng mẫu* và chùm tia ba*, hỗ trợ chuẩn bị mẫu TEM chất lượng cao với hiệu suất lớn cho các ứng dụng tiên tiến nhất.
*Tùy chọn
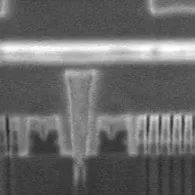 Hệ thống vi lấy mẫu và cơ chế định vị độ chính xác cao cho phép kiểm soát hướng mẫu để chống lại hiệu ứng rèm (chức năng ACE) và tạo ra các lá mẫu có độ dày đồng nhất.
Có chức năng định hướng mẫu (Bên trên)
Không có chức năng định hướng mẫu (Bên dưới)
Hệ thống vi lấy mẫu và cơ chế định vị độ chính xác cao cho phép kiểm soát hướng mẫu để chống lại hiệu ứng rèm (chức năng ACE) và tạo ra các lá mẫu có độ dày đồng nhất.
Có chức năng định hướng mẫu (Bên trên)
Không có chức năng định hướng mẫu (Bên dưới)
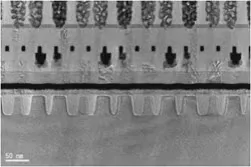
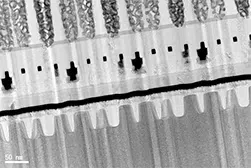 Hệ thống Ba chùm tia*: Cấu hình ba chùm tia giúp giảm thiểu hư hại do chùm ion Ga (Gallium) gây ra.
Hệ thống Ba chùm tia*: Cấu hình ba chùm tia giúp giảm thiểu hư hại do chùm ion Ga (Gallium) gây ra.
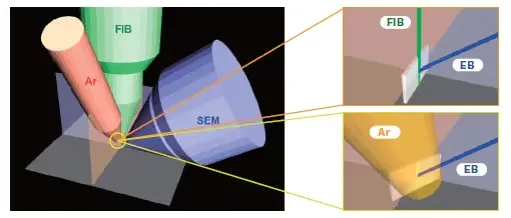 EB: Chùm điện tử
FIB: Chùm ion tập trung
Ar: Chùm ion Argon
EB: Chùm điện tử
FIB: Chùm ion tập trung
Ar: Chùm ion Argon

 En
En









