Hệ thống FIB-SEM phân tích 3D thời gian thực NX9000
Hệ thống FIB-SEM cho phân tích cấu trúc 3D thực thụ
Hệ thống FIB-SEM mới được phát triển từ Hitachi, NX9000, tích hợp một thiết kế tối ưu cho quá trình cắt lát nối tiếp độ phân giải cao đáp ứng các nhu cầu phân tích cấu trúc 3D hiện đại cũng như cho các phân tích TEM và 3DAP. Hệ thống FIB-SEM NX9000 cho phép đạt được độ chính xác cao nhất trong xử lý vật liệu cho nhiều lĩnh vực khác nhau liên quan đến vật liệu tiên tiến, thiết bị điện tử, mô sinh học, và nhiều ứng dụng khác.
-
Cột SEM và cột FIB được bố trí vuông góc để tối ưu hóa vị trí của các cột cho việc phân tích cấu trúc 3D.
-
Sự kết hợp giữa nguồn electron phát xạ trường lạnh độ sáng cao và hệ thống quang học độ nhạy cao hỗ trợ phân tích đa dạng các loại vật liệu, từ mô sinh học đến vật liệu từ tính.
-
Hệ thống vi lấy mẫu và hệ thống Ba chùm tia cho phép chuẩn bị mẫu chất lượng cao cho các ứng dụng TEM và đầu dò nguyên tử.
Cắt ion và quan sát ở góc tới trực diện trong thời gian thực để tạo ra hình ảnh phân tích thực thụ
Cột SEM và cột FIB được bố trí vuông góc với nhau để thực hiện việc ghi hình SEM ở góc tới trực diện đối với các mặt cắt ngang do FIB tạo ra.
Cách bố trí cột vuông góc này giúp loại bỏ hiện tượng biến dạng hình học, hiện tượng thu ngắn hình ảnh mặt cắt ngang, và sự dịch chuyển trường nhìn (FOV) trong quá trình ghi hình cắt lát nối tiếp—những vấn đề vốn không thể tránh khỏi ở các hệ thống FIB-SEM truyền thống. Các hình ảnh từ máy NX9000 cho phép phân tích cấu trúc 3D với độ chính xác cực cao. Ngoài ra, việc ứng dụng hiển vi quang học tương quan cũng trở nên dễ dàng hơn nhờ ưu thế của việc ghi hình điện tử trên bề mặt phẳng.
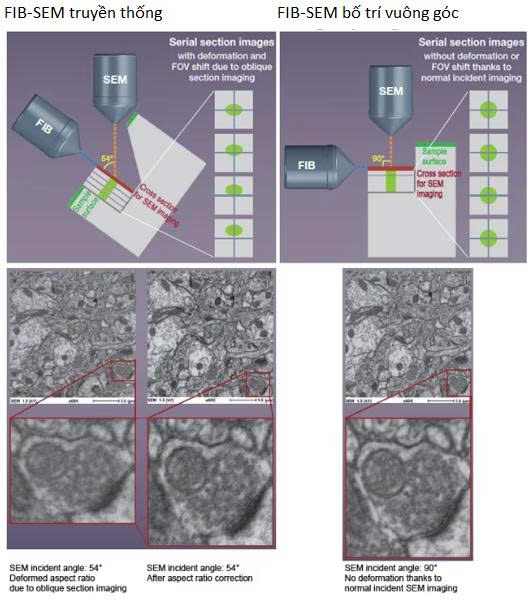
Mẫu: Nơ-ron não bộ của chuột
Mẫu được cung cấp bởi Tiến sĩ Yoshiyuki Kubota, Hệ thống xử lý thông tin thần kinh (NIPS)
Các ứng dụng Cut & See, 3D-EDS¹, 3D-EBSD¹ có sẵn cho nhiều loại vật liệu
Cắt & Quan sát (Cut&See)
Tính năng này hỗ trợ ghi hình độ phân giải cao và độ tương phản cao cho các loại mô sinh học, bán dẫn và vật liệu từ tính như thép và niken ở thế gia tốc thấp.
Các hình ảnh cắt lát nối tiếp có thể được thu thập với hiệu suất cao nhờ vào thiết kế hình học hợp lý giữa cột ion và cột electron.
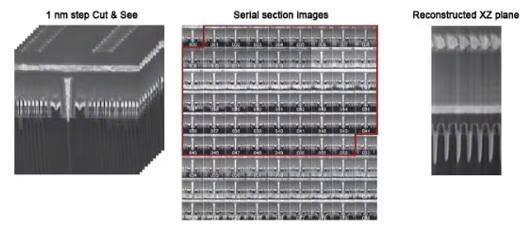
Mẫu: Bộ nhớ NAND flash
Điện áp gia tốc SEM: 1 kV
Khoảng cách cắt: 1 nm
Số lần cắt: 300
3D-EDS*¹
Các hình ảnh SEM và bản đồ phân bố nguyên tố theo lát cắt nối tiếp có thể được thu thập bằng 3D-EDS. Bộ dò silicon drift diện tích lớn giúp giảm thời gian thu thập dữ liệu và cho phép lập bản đồ nguyên tố ở điện áp gia tốc thấp.
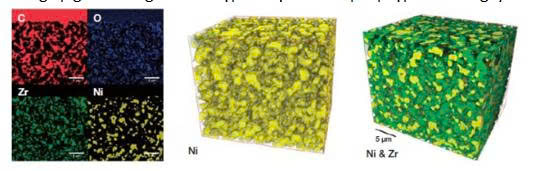
Mẫu: Điện cực pin nhiên liệu
Điện áp gia tốc SEM: 5 kV
Khoảng cách cắt: 100 nm
Số lần cắt: 212
Mẫu được cung cấp bởi giáo sư Naoki Shikazono, Đại học Tokyo
3D-EBSD*¹
Các tín hiệu SEM, FIB và EBSD được thu thập đồng thời cho 3D-EBSD mà không cần di chuyển bàn mẫu trong quá trình cắt lát và phân tích EBSD. Độ chính xác và hiệu suất của việc phân tích định hướng tinh thể 3D và phân đoạn mẫu mang lại chất lượng cao, đồng thời giảm thiểu việc phải hiệu chỉnh hậu xử lý.

Mẫu: Ni
Điện áp gia tốc SEM: 20 kV
Khoảng cách cắt: 150 nm
Số lần cắt: 150

 En
En









